联系我们
地址:武汉市洪山区珞瑜路1037号
电话:027-86666818
传真:027-86666818
邮箱:microtest_hust@126.com
焊点检测
发布时间:2019/08/12 点击量:428
由于IC芯片的特征尺寸要求越来越小,且复杂程度不断增加,使得企业开始寻求新的高密度封装技术,BGA封装技术应运而生。尽管BGA器件的性能和组装优于常规元器件,但BGA封装技术的发展仍受限于BGA焊点的质量和可靠性。
针对不同产品不同的焊点缺陷问题,需要选择适宜的检测方法。今天我们就来介绍一下BGA焊点缺陷或失效的几个常用的检测方法,帮助大家深入了解到不同检测方法的不同优势及典型案例,更好的进行选择。随着集成电路芯片对特征尺寸的要求越来越小,集成电路芯片的复杂度越来越高,企业开始寻求新的高密度封装技术,BGA封装技术应运而生。虽然BGA器件的性能和组装都优于传统器件,但BGA封装技术的发展仍然受到BGA焊点质量和可靠性的限制。
针对不同产品焊点的不同缺陷,有必要选择合适的检测方法。今天,我们将介绍几种常用的BGA焊点缺陷或失效检测方法,以帮助您了解不同检测方法和典型案例的不同优点,更好地进行选择。
无损检测方法:
1.焊点质量目视检查。电子产品的生产全过程可以进行外观检查。用高放大镜观察焊点,从外观上初步检测焊点的明显缺陷。目的:简单、快速、直观地观察焊点,观察焊点外是否有连续焊及周围表面情况。然而,目视检查的局限性很大。它只能在没有测试设备的情况下作为初步判断,不可能判断焊点是否有其他缺陷或焊点表面是否有孔。
2.焊缝质量的X射线检测.X射线检测是一种非破坏性物理透视法,它利用X射线在不破坏芯片的情况下,检测出元件内部的包装,如气泡、裂纹和异常的结合线。
3.X射线。对于无法目视检测到样品的位置,可以记录X射线穿透不同密度后的光强变化。对比效果可以形成图像,显示被测物体的内部结构,然后在不破坏被测物体的情况下,观察被测物体内有问题的区域。目的:X射线扫描能快速有效地观察和识别BGA焊接缺陷,如虚焊和虚焊、BGA和PCB内部位移分析、架桥和短路等。
3.X射线。对于无法目视检测到样品的位置,可以记录X射线穿透不同密度后的光强变化。对比效果可以形成图像,显示被测物体的内部结构,然后在不破坏被测物体的情况下,观察被测物体内有问题的区域。目的:X射线扫描能快速有效地观察和识别BGA焊接缺陷,如虚焊和虚焊、BGA和PCB内部位移分析、架桥和短路等。
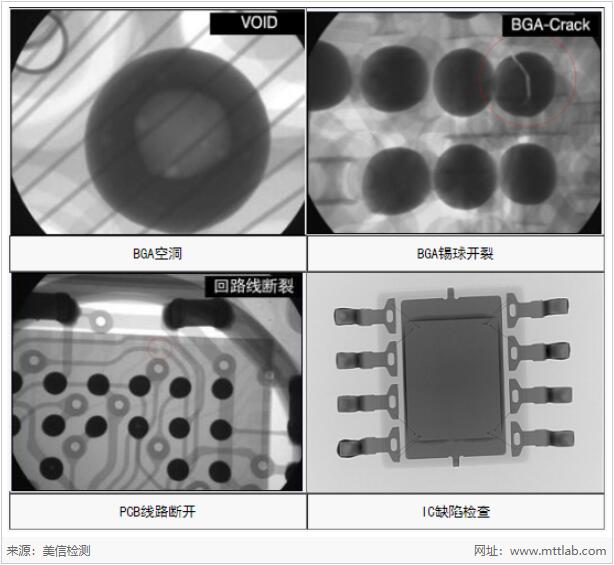
但是2DX射线有一些局限性。它只能观察二维平面图像。其原理是在二维显示屏上显示三维真实样品进行成像。对于结构复杂的产品,不同深度方向的信息是重叠的,很容易混淆。例如,当组件存在于同一位置的不同表面上时,由焊料形成的阴影会重叠,这会影响测试结果的准确性。因此,结构复杂的产品往往被用于初步和快速的测定。
4.三维X射线(CT扫描)3DX射线很好地解决了二维X射线的局限性。它可以呈现三维图像,具有高密度分辨率和空间分辨率,还可以实现模拟断层图像。可以很好地解决BGA焊点的缺陷。目的:清晰、准确地观察BGA焊点的焊接质量和结构缺陷,显示焊接内部缺陷的形状、位置和尺寸。
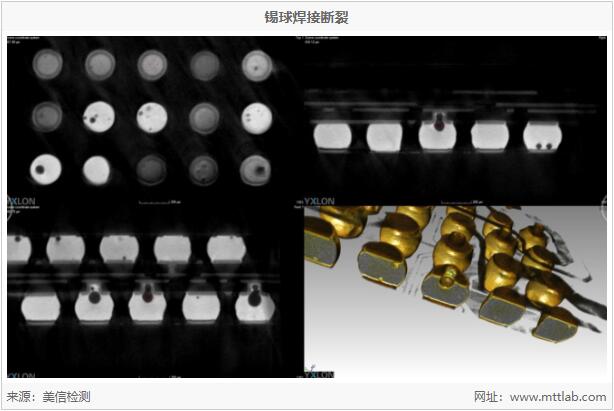
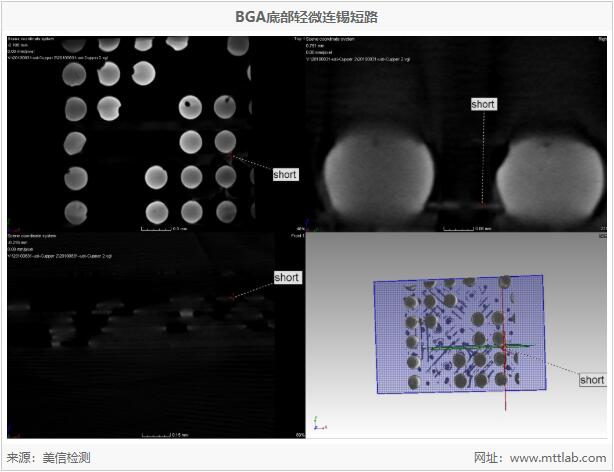
目视检查和2DX射线在上述无损检测方法中有局限性。目前,最先进的无损检测技术3DX射线(CT扫描)能很好地解决焊点缺陷问题,但检测成本较高。如果产品可以销毁,则可以使用下一步。应测试破坏性检测方法。
破坏性检测方法
1.红墨水法检测焊点质量
红墨水测试适用于验证印制电路板上BGA和IC的焊接条件。通过对印刷电路板和集成电路元件焊点染色的观察和分析,判断了焊接裂纹。红墨水测试的原理是利用液体的渗透性。将焊点放入红色染料中,染料渗透到焊点的裂缝中。干燥后,焊点被强行分离。观察裂纹处界面的颜色状态,以确定焊点是否断裂。简单地说,它分为五个步骤:切割渗透干燥分离观察。目的:一般来说,通过红墨水测试可以看到整个BGA下所有锡球的焊接现象。电子装配焊接质量分析是一种常用的方法。可检测电子零件焊接过程中是否存在虚焊、虚焊、裂纹等缺陷。
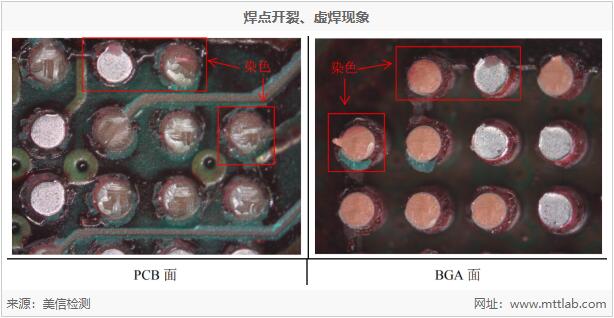
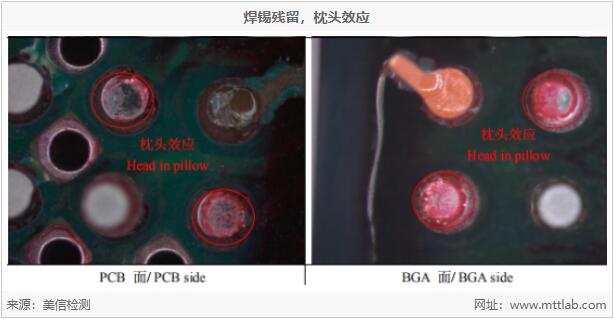

焊点质量切片分析,是PCB/PCBA失效分析的一项重要技术。切片分析比红墨水测试更耗时。切片分析的过程是取样清洗真空镶嵌磨抛光微蚀(如有必要)分析。切片质量的好坏直接影响到故障定位确认的准确性,因此检测人员的能力非常高。截面分析目的:不仅可用于PCBA焊点的内部空隙、界面结合、润湿质量评价,还可用于PCBA焊点的质量检测。

扫描电镜与能谱仪的结合
在切片分析的基础上,为了进一步了解焊点缺陷产生的原因,可以利用扫描电镜和能谱仪分析焊点失效的原因。
通过以上几种焊点缺陷检测方法的介绍,我们相信您可以根据自己的需要选择最合适的方法。美信检测实验室可以提供上述所有焊点检测服务,愿为您的产品质量保驾护航!
最后,如何改进BGA焊接工艺在电路板产品生产中的应用?我们提供了以下措施供您参考和交流:
BGA焊接工艺改进措施
(1)电路板、芯片预热除湿。包装在托盘上的BGA应在焊接前在120 C下烘烤4-6小时。
(2)清洁焊盘,去除留在印刷电路板表面的助焊剂和焊膏。
(3)必须使用新的辅助材料均匀地涂抹焊膏和助焊剂,焊膏必须搅拌均匀,焊膏粘度和焊膏量必须适当,以确保焊膏在熔化过程中不会焊接。
(4)BGA芯片上的每个焊球必须与印刷电路板上的每个对应焊点对齐。
_ 在回流焊过程中,应正确选择各区域的加热温度和时间,注意加热速度。一般来说,最大加热速率在100前不超过6秒,在100后不超过3秒。在冷却区,最大冷却速度不超过6秒。因为过多的加热和冷却速度会损坏印刷电路板和芯片,这种损坏有时肉眼看不到。同时,不同的芯片和焊膏应选择不同的加热温度和时间;对于免清洗焊膏,其活性低于非免清洗焊膏,因此,焊接温度不宜过高,焊接时间不宜过长。防止焊锡颗粒氧化。
在印刷电路板设计中,印刷电路板上所有BGA焊点的焊盘应设计成相同的尺寸。如果必须在焊盘下方设计一些通孔,还应找到合适的印刷电路板制造商,以确保所有焊盘尺寸相同,焊盘上的焊料数量和高度相同。



